近年來,隨著電子信息產(chǎn)業(yè)的快速發(fā)展,集成電路用濺射靶材也得到了較大發(fā)展���。用于制造半導(dǎo)體芯片的金屬靶材中,常見的濺射靶材有Ta����、Ti���、Al、Co和Cu等有色金屬��。其中集成電路制造用金屬濺射靶材中用量最大的是超高純鋁[>99.999%]和超高純鋁合金靶材�����,用來濺射阻擋層的是超高純鈦靶材��。在大規(guī)模集成電路中�����,金屬互連電遷移為主要失效機(jī)制之一���。在大電流密度下�����,鋁線易發(fā)生電遷移導(dǎo)致鋁互連線薄膜上形成突起和空洞,從而降低集成電路的運(yùn)行效率和可靠性�。Cu的電阻率要比Al約低35%���,抗電遷移能力也較強(qiáng);并且隨著集成電路的高度規(guī)模化發(fā)展��,集成化程度越來越高�,對用于制造互線和阻擋層的濺射靶材提出了更高的技術(shù)要求,在深亞微米工藝中[≤0.18μm]���,銅將逐步代替鋁成為硅片上金屬化布線的材料����,超高純銅靶材得以更多的應(yīng)用�,與之相應(yīng)的用來濺射阻擋層的是高純鉭靶材
隨著作為濺射阻擋層鍍膜材料的高純鉭靶材用量增大,其對靶材性能要求也越來越高���,如要求濺射靶材尺寸越來越大�,微觀織構(gòu)越精細(xì)均勻等�。因此對于濺射靶材的制備工藝研究也逐漸受到關(guān)注B,目前,高純鉭濺射靶材的制備工藝主要有熔煉鑄錠法和粉末冶金法��。通過介紹上述兩種工藝制備產(chǎn)品的特點(diǎn)以及目前國內(nèi)外生產(chǎn)現(xiàn)狀等���,為廣大科研工作者提供參考����。
1、高純鉭濺射靶材制備工藝
1.1熔煉鑄錠法制備高純鉭濺射靶材
熔煉鑄錠法是目前制備鉭濺射靶材的主要方法���,一般是將鉭原料進(jìn)行熔煉[電子束或電弧�����、等離子熔煉等]�、鑄造��,將得到的錠或坯料反復(fù)進(jìn)行熱鍛��、退火��,再進(jìn)行軋制����、退火,精加工后而成靶材����。生產(chǎn)工藝流程如圖1所示。錠或坯料經(jīng)過熱鍛破壞鑄造組織,使氣孔或偏析擴(kuò)散���、消失,再通過退火使其再結(jié)晶化���,從而提高組織的致密化和強(qiáng)度���。

為保證靶材能夠?yàn)R射高質(zhì)量的薄膜,一般對鉭濺射靶材有很高的純度要求�����,通常靶材純度越高����,薄膜質(zhì)量相對越好。如在集成電路上使用時(shí)�,由于鈾和釷有α衰變,α粒子會造成半導(dǎo)體材料中器件電擊穿�,要求鈾和釷的含量必須要低于μg/kg級的水平;堿金屬鈉鉀離子易擴(kuò)散到絕緣層[SiO2]中去,并以電的載體進(jìn)行活動;鐵元素可能會降低器件性能;因此對鈉鉀雜質(zhì)��、鐵元素也有嚴(yán)格要求����。氣體元素[C����、N���、O��、S等]過高會降低靶材濺射性能����,而其它難熔金屬元素鎢����、鉬、鈮等元素也要求盡量降低�。熔煉鑄錠法可以制備出高純或超純的鉭濺射靶材,一般可達(dá)4N以上,商用鉭靶化學(xué)雜質(zhì)元素分析見表1�。
表1商用鉭靶[4~5N]化學(xué)元素分析表
| 化學(xué)雜質(zhì) | Fe | Na | Cr | Ni | Si | Mn | Mg | Zr | Al | Cu | U |
| 含量/mg·kg-1 | <0.1 | <0.1 | <0.1 | <0.1 | <0.1 | <0.1 | <0.1 | <0.1 | <0.1 | <0.1 | <0.0005 |
| 化學(xué)雜質(zhì) | Th | Ti | W | Mo | Nb | Au | Co | C | 0 | N | S |
| 含量/mg·kg-1 | <0.001 | <0.1 | <1 | <1 | <1 | <10 | <0.1 | 10 | 20 | 10 | 10 |
如果制備的鉭濺射靶材中含有孔隙,則會極大影響濺射性能����,如濺射過程中若是含有氣體的孔隙被打通就可能會釋放出氣體,令濺射過程的瞬間不穩(wěn)定���,甚至產(chǎn)生電弧現(xiàn)象���,使得沉積膜均勻性難以保證�,因此�����,鉭濺射靶材應(yīng)保證致密度��。通常熔煉鑄錠法制備的鉭靶材致密度相對較好����。
靶材晶粒尺寸和晶粒尺寸的均勻性也是影響靶材濺射性能的重要因素之一����。一般來說,熔煉錠或坯料晶粒粗大�,通常直徑在50mm以上,經(jīng)過熱鍛和再結(jié)晶退火后��,可以得到100μm以下的晶粒�����。如文獻(xiàn)提到,將純度[除去氧和其它氣體雜質(zhì)]為99.998%以上�����、高為200mm����、直徑為200mm、晶粒尺寸為55mm左右的電子束熔煉錠坯料��,經(jīng)反復(fù)鍛造���、軋制����、再結(jié)晶退火等���,可獲得平均晶粒尺寸在110μm以下�����、晶粒直徑偏差為±20%以下�����、且組織均勻�����、鍍膜均勻性較好的鉭濺射靶��。但是熔煉鑄錠法制備靶材�,仍存在靶材晶粒尺寸和晶粒織構(gòu)取向均勻性較難控制的缺點(diǎn)�����,易產(chǎn)生帶狀織構(gòu)��,如圖2所示�����。

1.2粉末冶金法制備高純鉭濺射靶材
粉末冶金法制備高純鉭靶材的方法主要有熱壓�、熱等靜壓�����、冷等靜壓真空燒結(jié)等�,工藝流程如圖3所示�。目前較為常見的粉末冶金制備鉭濺射靶材法主要為熱壓和熱等靜壓法���,如有文獻(xiàn)中提到����,通過將金屬粉末表面氮化的方法�����,可以獲得氧含量在300 mg/kg以下����,氮含量在10mg/kg以下的鉭粉,然后裝入模具�,再經(jīng)冷壓成型和熱等靜壓成型或其它燒結(jié)等方法,可獲得純度為99.95%以上��、平均晶粒尺寸小于50μm�����,甚至10μm��,織構(gòu)隨機(jī)�����、且沿靶材表面和厚度方向織構(gòu)均勻的鉭靶。

而對于冷等靜壓��,再進(jìn)行真空燒結(jié)制備高純鉭濺射靶材的方法���,文獻(xiàn)資料較少��,目前尚不成熟�,以下是進(jìn)行的初步探索試驗(yàn)�。取平均粒徑為8.0μm的鉭粉,裝入包套模具內(nèi)��。然后進(jìn)行冷等靜壓成型�����,成型壓力220 MPa,保壓20 min;將成型后的鉭坯置于真空爐內(nèi)進(jìn)行燒結(jié)���,燒結(jié)溫度最高為2100℃,保溫6~8h;然后對燒結(jié)后鉭進(jìn)行軋制����、再結(jié)晶退火等�����,再進(jìn)行精加工后即為成品����。下面從純度����、孔隙度、晶粒尺寸和織構(gòu)幾個(gè)方面對靶材成品性能進(jìn)行分析��。
1.2.1純度
該試驗(yàn)制備的鉭靶材化學(xué)雜質(zhì)分析結(jié)果見表2�����。從表2可以看出����,同熔煉錠法制備鉭靶[表1]相比,該試驗(yàn)制備鉭靶的化學(xué)雜質(zhì)含量普遍偏高���,尤其是氣體雜質(zhì)“O”含量�,遠(yuǎn)高于商用鉭靶中氧元素的含量。作為半導(dǎo)體用濺射靶材���,通常要求“O”含量在100 mg/kg以下�����。而該試驗(yàn)制備的鉭濺射靶�,較難保證低的氣體“O”雜質(zhì)含量�。
表2鉭靶材化學(xué)雜質(zhì)元素分析表
| 化學(xué)雜質(zhì) | Fe | Na | Cr | Ni | Si | Mn | Mg | Zr | Al | Cu |
| 含量/mg·kg-1 | <10 | <10 | <10 | < | <10 | <1 | <10 | 11 | <1 | <1 |
| 化學(xué)雜質(zhì) | Ti | W | Mo | Nb | Cd | Co | C | 0 | N | S |
| 含量/mg·kg-1 | <1 | <10 | <10 | <10 | <5 | <1 | 70 | 750 | 50 | 7 |
1.2.2晶粒尺寸
靶材的晶粒尺寸及其均勻性對靶材濺射性能有重要影響,極大規(guī)模集成電路用半導(dǎo)體濺射靶材要求靶材有合適的晶粒尺寸[小于100μm或更小40μm]�,并保證其均勻性。該試驗(yàn)方法制備的鉭靶材�����,燒結(jié)后晶粒尺寸為60~80μm���,經(jīng)少量加工軋制便可獲得超細(xì)�、均勻性好的晶粒����,晶粒尺寸在15~40μm范圍內(nèi)�����,靶材金相照片如圖4所示。因此�,粉末冶金法制備鉭濺射靶材,更易獲得超細(xì)��、均勻性好的晶粒��。
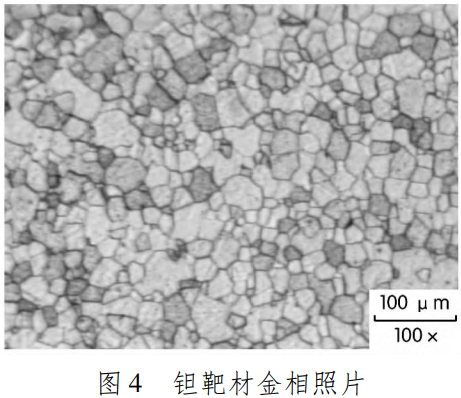
1.2.3孔隙度
試驗(yàn)制備的鉭靶材成品相對密度為99.65%�����,從圖4的金相照片來看�,尚且沒有明顯的孔洞,致密度較好�。
1.2.4織構(gòu)
一般來說,靶材織構(gòu)取向越隨機(jī)�,鍍出的膜厚均勻性越好,織構(gòu)取向越強(qiáng)�,鍍膜的均勻性越差通過采用EBSD[電子背散射衍射]手段對該試驗(yàn)制備的鉭靶材進(jìn)行分析,如圖5所示����。其中{111}織構(gòu)比例為19.6%。由圖5可以看出�����,該鉭靶材具有隨機(jī)、均勻的織構(gòu)取向�����,沒有帶狀織構(gòu)���。因此����,相比熔煉鑄錠法制備鉭靶材易產(chǎn)生織構(gòu)取向����,粉末冶金法可避免鉭靶中產(chǎn)生強(qiáng)的織構(gòu)取向現(xiàn)象,更易獲得織構(gòu)隨機(jī)���、均勻性較好的靶材��。

隨著半導(dǎo)體硅片尺寸的增大����,濺射靶材的尺寸也在向大型化發(fā)展�,為保證濺射過程中靶材的穩(wěn)定性和利用率,還要求靶材在三維方向上要保持晶粒尺寸和織構(gòu)的均一����,以獲得優(yōu)異的薄膜性能。粉末冶金法制備鉭靶材更有利于保證其微觀組織的均勻性�����。該方法其關(guān)鍵在于選擇高純���、超細(xì)粉末作為原料和能夠快速致密化的成型燒結(jié)技術(shù)�,以保證靶材的低孔隙率�,控制晶粒度,并且制備過程嚴(yán)格控制雜質(zhì)元素的引入���。而其中的鉭粉原料氣體雜質(zhì)[O���、C等]含量控制,燒結(jié)工序等是其技術(shù)難點(diǎn)���。
2��、國內(nèi)外現(xiàn)狀及展望
我國雖有豐富的原材料����,但由于此前全球只有美國、日本具備濺射高純靶材的生產(chǎn)能力��,關(guān)鍵技術(shù)及市場一直被國外公司壟斷��。目前掌握鉭靶材制造技術(shù)的�����,主要有日本日礦公司[Nikko]����、美國普蘭克西公司[Praxair]、美國霍尼韋爾公司[Honeywell]���、美國東曹公司[ Tosoh]等四家公司���。近年來,國內(nèi)半導(dǎo)體靶材生產(chǎn)廠家經(jīng)過努力�����,也取得了較大的進(jìn)步�����,如寧夏東方鉭業(yè)股份有限公司已獲得穩(wěn)定的高純鉭濺射靶材生產(chǎn)工藝路線����。盡管與國外技術(shù)還有一些差距,堅(jiān)信將來一定會突破技術(shù)難關(guān)��,躋身于國際市場�����。熔煉鑄錠法制備高純鉭濺射靶材�����,可獲得高純或超純且致密性優(yōu)良的靶材����,這對于獲取高性能靶材是非常重要的,因此目前該方法仍是制造鉭濺射靶材的主流方法����。粉末冶金法可獲得晶粒更細(xì)、性能更均一的靶材�����,具有潛在優(yōu)勢,盡管國外有公司稱已經(jīng)生產(chǎn)出粉末冶金坯制造的鉭板��,能夠符合制造靶的要求��,但目前仍未被廣泛使用于市場���,或許還存在一些技術(shù)瓶頸����,相信隨著研究進(jìn)展�,必將克服技術(shù)壁壘,制備出性能更優(yōu)異的高純鉭濺射靶材���。
參考文獻(xiàn):
[1]潘倫桃�,李彬��,鄭愛國���,等.鉭在集成電路中的應(yīng)用[].稀有金屬,2003,27[1]:28-34.
[2]尚再艷�,江軒�����,李勇軍,等.集成電路制造用濺射靶材[].稀有金屬,2005,29[4]:475-477.
[3]宗兆翔��,杜磊��,莊奕琪��,等.超大規(guī)模集成電路互連電遷移自由體積電阻模型[].物理學(xué)報(bào),2005,54[12]:5872-5877.
[4]王俊忠����,吉元����,王曉冬,等.Al互連線和Cu互連線的顯微結(jié)構(gòu)[J].物理學(xué),2007,56[1]:371-375.
[5]楊謙.高純鉭形變與退火過程中微觀組織結(jié)構(gòu)及織構(gòu)演變的研究[D].重慶:重慶大學(xué)�,2010.
[6]羅俊鋒����,丁照崇��,董亭義�����,等.釕金屬濺射靶材燒結(jié)工藝研究[J].粉末冶金工業(yè),2012,22[1]:28-31.
[7]劉貴材���,婁燕雄.鉭鈮譯文集[M].長沙:中南大學(xué)出版社��,2009.118-157.
[8]仙田真一郎����,福島篤志.鉭濺射靶[P].中國專利:103069044 A,2013-04-24.
[9]Christopher A, Michaluk,Gilbertsville,et al. Power Metallurgy Sput-tering Targets and Methods of Producing Same[P].US:7067197 B2,2006-06-27.
[10]陳明���,朱曉光���,王欣平,等.Ta晶粒細(xì)化工藝及組織���、織構(gòu)的研究印.熱加工工藝,2010,39[8]:26-28.
[11]鄧超.多晶高純鉭板軋制變形與退火行為研究[D].重慶:重慶大學(xué),2014.
[12]儲志強(qiáng).國內(nèi)外磁控濺射靶材的現(xiàn)狀及發(fā)展趨勢[].金屬材料與冶金工程,2011,[4]:44-49.
[13]羅俊峰.粉末冶金靶材的制備與應(yīng)用[].中國金屬通報(bào),2011,[31]:40-41.
[14]張青來�,賀繼弘.粉末冶金高純鉻和鉻合金濺射靶材燒結(jié)工藝研究[].金屬成型工藝,2006,21[6]:83-85.
[15]呂建玲.鉭鈮資源現(xiàn)狀及我國鉭鈮工業(yè)的發(fā)展[J].環(huán)球市場信息導(dǎo)報(bào)���,2013,16:13.
[16]張春恒����,吳紅,李桂鵬�,等.一種應(yīng)用于半導(dǎo)體的鉭板制備工藝研究[].材料開發(fā)與應(yīng)用,2010,[6]:29-32.
(注,原文標(biāo)題:高純鉭濺射靶材制備工藝進(jìn)展_鄭金鳳)
相關(guān)鏈接